
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
చిప్ తయారీలో SiGe: ఒక ప్రొఫెషనల్ న్యూస్ రిపోర్ట్
సెమీకండక్టర్ మెటీరియల్స్ యొక్క పరిణామం
ఆధునిక సెమీకండక్టర్ టెక్నాలజీ రంగంలో, సూక్ష్మీకరణ వైపు కనికరంలేని డ్రైవ్ సాంప్రదాయ సిలికాన్-ఆధారిత పదార్థాల పరిమితులను పెంచింది. అధిక పనితీరు మరియు తక్కువ విద్యుత్ వినియోగం కోసం డిమాండ్లను తీర్చడానికి, SiGe (సిలికాన్ జెర్మేనియం) దాని ప్రత్యేక భౌతిక మరియు విద్యుత్ లక్షణాల కారణంగా సెమీకండక్టర్ చిప్ తయారీలో ఎంపిక యొక్క మిశ్రమ పదార్థంగా ఉద్భవించింది. ఈ వ్యాసం దాని గురించి లోతుగా పరిశీలిస్తుందిఎపిటాక్సీ ప్రక్రియSiGe మరియు ఎపిటాక్సియల్ గ్రోత్, స్ట్రెయిన్డ్ సిలికాన్ అప్లికేషన్లు మరియు గేట్-ఆల్-అరౌండ్ (GAA) నిర్మాణాలలో దాని పాత్ర.
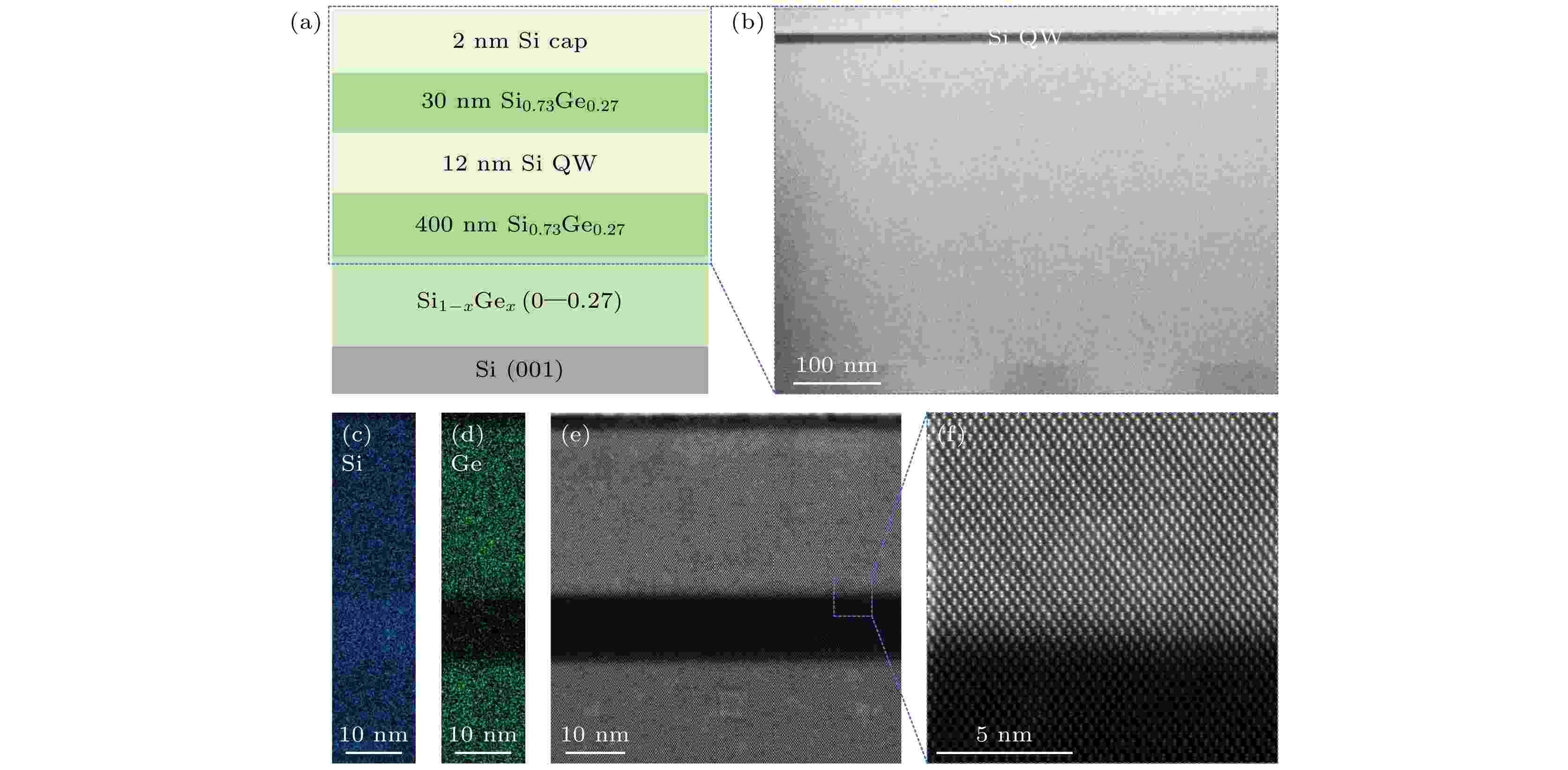
SiGe ఎపిటాక్సీ యొక్క ప్రాముఖ్యత
1.1 చిప్ తయారీలో ఎపిటాక్సీకి పరిచయం:
ఎపిటాక్సీ, తరచుగా ఎపి అని సంక్షిప్తీకరించబడుతుంది, అదే లాటిస్ అమరికతో ఒకే-క్రిస్టల్ ఉపరితలంపై ఒకే-క్రిస్టల్ పొర పెరుగుదలను సూచిస్తుంది. ఈ పొర ఏదైనా కావచ్చుహోమోపిటాక్సియల్ (Si/Si వంటివి)లేదా హెటెరోపిటాక్సియల్ (SiGe/Si లేదా SiC/Si వంటివి). మాలిక్యులర్ బీమ్ ఎపిటాక్సీ (MBE), అల్ట్రా-హై వాక్యూమ్ కెమికల్ ఆవిరి నిక్షేపణ (UHV/CVD), అట్మాస్ఫియరిక్ మరియు రిడ్యూస్డ్ ప్రెజర్ ఎపిటాక్సీ (ATM & RP Epi)తో సహా ఎపిటాక్సియల్ పెరుగుదల కోసం వివిధ పద్ధతులు ఉపయోగించబడతాయి. ఈ వ్యాసం సిలికాన్ (Si) మరియు సిలికాన్-జెర్మానియం (SiGe) యొక్క ఎపిటాక్సీ ప్రక్రియలపై దృష్టి సారిస్తుంది, సిలికాన్ను సబ్స్ట్రేట్ మెటీరియల్గా సెమీకండక్టర్ ఇంటిగ్రేటెడ్ సర్క్యూట్ ఉత్పత్తిలో విస్తృతంగా ఉపయోగిస్తారు.
1.2 SiGe ఎపిటాక్సీ యొక్క ప్రయోజనాలు:
ఈ సమయంలో జెర్మేనియం (Ge) యొక్క నిర్దిష్ట నిష్పత్తిని చేర్చడంఎపిటాక్సీ ప్రక్రియSiGe సింగిల్-క్రిస్టల్ పొరను ఏర్పరుస్తుంది, ఇది బ్యాండ్గ్యాప్ వెడల్పును తగ్గించడమే కాకుండా ట్రాన్సిస్టర్ యొక్క కట్-ఆఫ్ ఫ్రీక్వెన్సీ (fT)ని పెంచుతుంది. ఇది వైర్లెస్ మరియు ఆప్టికల్ కమ్యూనికేషన్ల కోసం అధిక-ఫ్రీక్వెన్సీ పరికరాలలో విస్తృతంగా వర్తించేలా చేస్తుంది. అంతేకాకుండా, అధునాతన CMOS ఇంటిగ్రేటెడ్ సర్క్యూట్ ప్రక్రియలలో, Ge మరియు Si మధ్య లాటిస్ అసమతుల్యత (సుమారు 4%) లాటిస్ ఒత్తిడిని పరిచయం చేస్తుంది, ఎలక్ట్రాన్లు లేదా రంధ్రాల కదలికను పెంచుతుంది మరియు తద్వారా పరికరం యొక్క సంతృప్త కరెంట్ మరియు ప్రతిస్పందన వేగం పెరుగుతుంది.
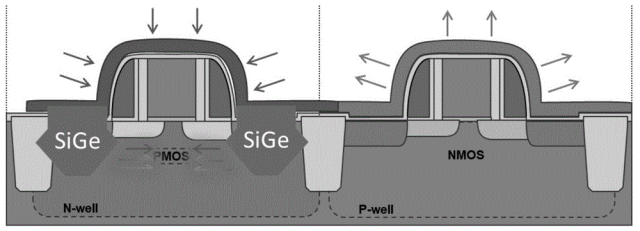
సమగ్ర SiGe ఎపిటాక్సీ ప్రక్రియ ప్రవాహం
2.1 ముందస్తు చికిత్స:
సిలికాన్ పొరలు కావలసిన ప్రక్రియ ఫలితాల ఆధారంగా ముందుగా చికిత్స చేయబడతాయి, ప్రాథమికంగా సహజ ఆక్సైడ్ పొర మరియు పొర ఉపరితలంపై మలినాలను తొలగించడం వంటివి ఉంటాయి. భారీగా డోప్ చేయబడిన సబ్స్ట్రేట్ పొరల కోసం, తదుపరి సమయంలో ఆటో-డోపింగ్ను తగ్గించడానికి బ్యాక్సీలింగ్ అవసరమా కాదా అని పరిగణనలోకి తీసుకోవడం చాలా ముఖ్యం.ఎపిటాక్సీ పెరుగుదల.
2.2 వృద్ధి వాయువులు మరియు పరిస్థితులు:
సిలికాన్ వాయువులు: సిలేన్ (SiH₄), డైక్లోరోసిలేన్ (DCS, SiH₂Cl₂), మరియు ట్రైక్లోరోసిలేన్ (TCS, SiHCl₃) మూడు సాధారణంగా ఉపయోగించే సిలికాన్ వాయువు మూలాలు. SiH₄ తక్కువ-ఉష్ణోగ్రత పూర్తి ఎపిటాక్సీ ప్రక్రియలకు అనుకూలంగా ఉంటుంది, అయితే TCS, దాని వేగవంతమైన వృద్ధి రేటుకు ప్రసిద్ధి చెందింది, మందపాటి తయారీకి విస్తృతంగా ఉపయోగించబడుతుంది.సిలికాన్ ఎపిటాక్సీపొరలు.
జెర్మేనియం వాయువు: జెర్మేన్ (GeH₄) అనేది జెర్మేనియంను జోడించడానికి ప్రాథమిక మూలం, SiGe మిశ్రమాలను రూపొందించడానికి సిలికాన్ మూలాలతో కలిపి ఉపయోగించబడుతుంది.
సెలెక్టివ్ ఎపిటాక్సీ: సాపేక్ష రేట్లను సర్దుబాటు చేయడం ద్వారా ఎంపిక వృద్ధి సాధించబడుతుందిఎపిటాక్సియల్ నిక్షేపణమరియు సిటు ఎచింగ్లో, క్లోరిన్-కలిగిన సిలికాన్ గ్యాస్ DCS ఉపయోగించి. సిలికాన్ ఉపరితలంపై Cl పరమాణువుల శోషణం ఆక్సైడ్లు లేదా నైట్రైడ్ల కంటే తక్కువగా ఉండటం వలన సెలెక్టివిటీ ఏర్పడుతుంది, ఇది ఎపిటాక్సియల్ పెరుగుదలను సులభతరం చేస్తుంది. SiH₄, Cl పరమాణువులు లేకపోవడం మరియు తక్కువ క్రియాశీలత శక్తి, సాధారణంగా తక్కువ-ఉష్ణోగ్రత పూర్తి ఎపిటాక్సీ ప్రక్రియలకు మాత్రమే వర్తించబడుతుంది. మరొక సాధారణంగా ఉపయోగించే సిలికాన్ మూలం, TCS, తక్కువ ఆవిరి పీడనాన్ని కలిగి ఉంటుంది మరియు గది ఉష్ణోగ్రత వద్ద ద్రవంగా ఉంటుంది, దీనిని ప్రతిచర్య గదిలోకి ప్రవేశపెట్టడానికి H₂ బబ్లింగ్ అవసరం. అయినప్పటికీ, ఇది సాపేక్షంగా చవకైనది మరియు దాని వేగవంతమైన వృద్ధి రేటు (5 μm/నిమి వరకు) మందమైన సిలికాన్ ఎపిటాక్సీ పొరలను పెంచడానికి తరచుగా ఉపయోగించబడుతుంది, ఇది సిలికాన్ ఎపిటాక్సీ పొర ఉత్పత్తిలో విస్తృతంగా వర్తించబడుతుంది.
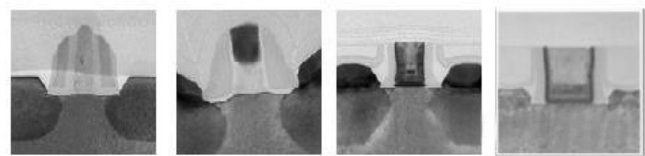
ఎపిటాక్సియల్ పొరలలో స్ట్రెయిన్డ్ సిలికాన్
సమయంలోఎపిటాక్సియల్ పెరుగుదల, ఎపిటాక్సియల్ సింగిల్-క్రిస్టల్ Si రిలాక్స్డ్ SiGe లేయర్పై జమ చేయబడింది. Si మరియు SiGe మధ్య లాటిస్ అసమతుల్యత కారణంగా, Si సింగిల్-క్రిస్టల్ పొర అంతర్లీన SiGe పొర నుండి తన్యత ఒత్తిడికి లోనవుతుంది, NMOS ట్రాన్సిస్టర్లలో ఎలక్ట్రాన్ మొబిలిటీని గణనీయంగా పెంచుతుంది. ఈ సాంకేతికత సంతృప్త ప్రవాహాన్ని (Idsat) పెంచడమే కాకుండా పరికర ప్రతిస్పందన వేగాన్ని మెరుగుపరుస్తుంది. PMOS పరికరాల కోసం, SiGe పొరలు ఛానల్పై సంపీడన ఒత్తిడిని పరిచయం చేయడానికి, హోల్ మొబిలిటీని పెంచడానికి మరియు సంతృప్త ప్రవాహాన్ని పెంచడానికి ఎచింగ్ చేసిన తర్వాత మూలం మరియు కాలువ ప్రాంతాలలో ఎపిటాక్సియల్గా పెంచబడతాయి.
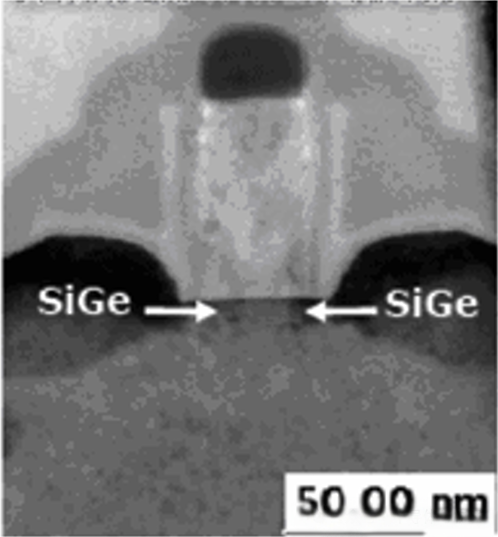
GAA స్ట్రక్చర్స్లో త్యాగం చేసే పొరగా SiGe
గేట్-ఆల్-అరౌండ్ (GAA) నానోవైర్ ట్రాన్సిస్టర్ల తయారీలో, SiGe పొరలు త్యాగం చేసే పొరలుగా పనిచేస్తాయి. క్వాసి-అటామిక్ లేయర్ ఎచింగ్ (క్వాసి-ALE) వంటి హై-సెలెక్టివిటీ అనిసోట్రోపిక్ ఎచింగ్ టెక్నిక్లు, నానోవైర్ లేదా నానోషీట్ స్ట్రక్చర్లను రూపొందించడానికి SiGe లేయర్లను ఖచ్చితంగా తొలగించడానికి అనుమతిస్తాయి.
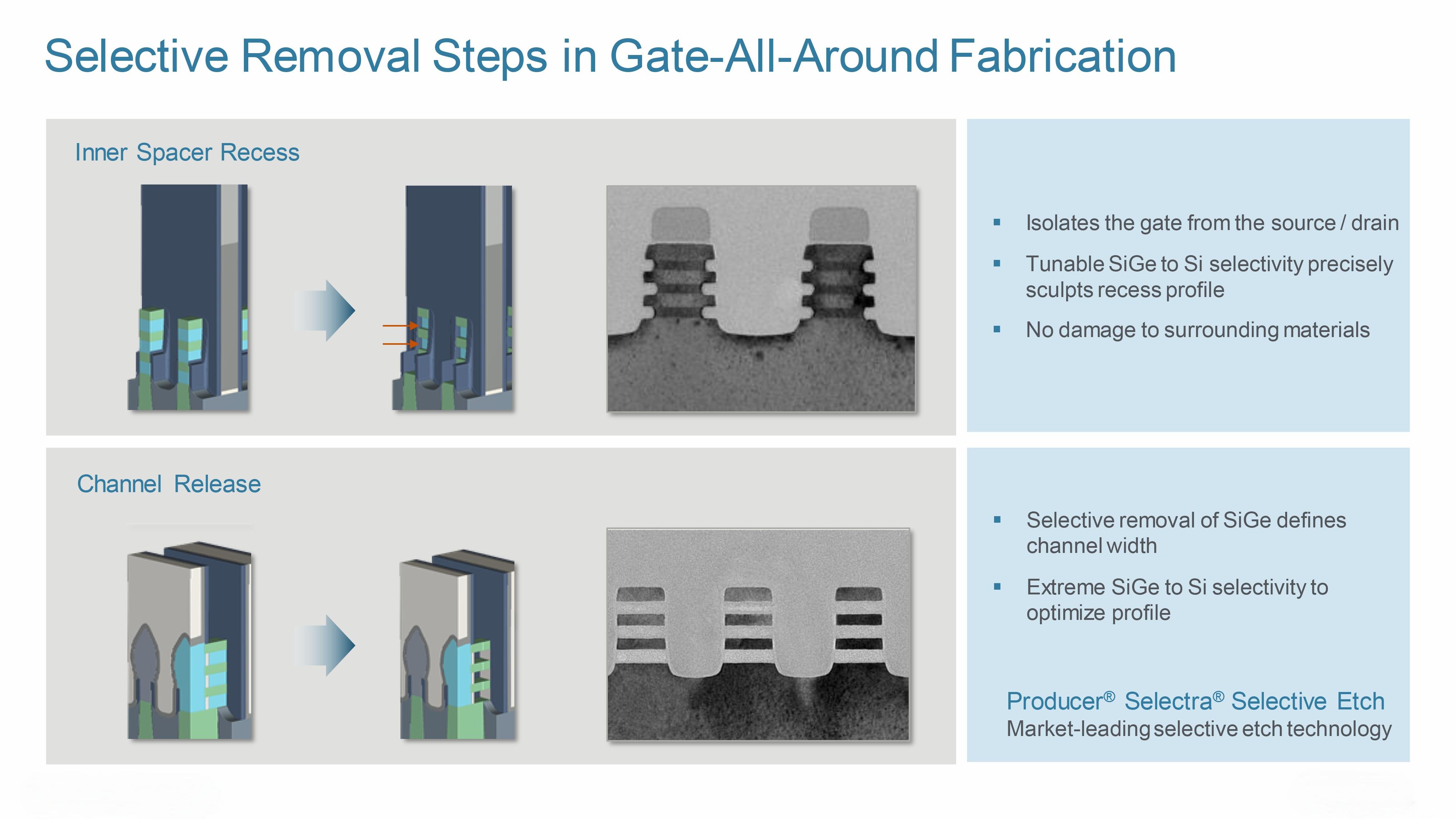
సెమికోరెక్స్లో మేము ప్రత్యేకత కలిగి ఉన్నాముSiC/TaC పూతతో కూడిన గ్రాఫైట్ సొల్యూషన్స్సెమీకండక్టర్ తయారీలో Si ఎపిటాక్సియల్ గ్రోత్లో వర్తింపజేయబడింది, మీకు ఏవైనా విచారణలు ఉంటే లేదా అదనపు వివరాలు అవసరమైతే, దయచేసి మమ్మల్ని సంప్రదించడానికి వెనుకాడకండి.
సంప్రదింపు ఫోన్: +86-13567891907
ఇమెయిల్: sales@semicorex.com




